Maseni spektrometar sekundarnih iona
Oprema je kupljena u sklopu projekta Razvoj istraživačke infrastrukture na kampusu Sveučilišta u Rijeci (RISK), koji je sufinancirala Europska unija iz Europskog fonda za regionalni razvoj.

SIMS (Masena spektroskopija sekundarnih iona, Secondary Ion Mass Spectroscopy) je analitička tehnika za elementnu analizu i mjerenje ultraniskih koncentracija primjesa i nečistoća u različitim materijalima i tankim filmovima s posebno značajnom primjenom u fizici poluvodiča i poluvodičkoj tehnologiji. Detekcijske granice su za većinu elemenata u ppm ili čak u ppb području, pa je po tome SIMS jedna od najosjetljivijih tehnika za elementnu analizu.
SIMS se temelji na detekciji iona (sekundarnih iona) izbijenih s površine uzorka za vrijeme bombardiranja površine energetskim ionima (primarnim ionima). Primarni ioni erodiraju površinu (sputtering), a mali postotak izbačenih atoma ili molekula je ioniziran (sekundarni ioni). Kao izvor primarnih iona naš uređaj koristi ione Cs+, O2+ ili Ar+, a može detektirati pozitivne ili negativne sekundarne ione (atomske i molekularne) u rasponu 1amu do 500 amu, koristeći kvadrupolni maseni analizator.
U statičkom modu, SIMS se koristi za analizu elemenata na samoj površini uzoraka, a u dinamičkom modu, kroz eroziju površine (stvaranje kratera na površini), za dubinsko profiliranje elemenata.
Naš instrument posjeduje i mogućnost detekcije neutralnih atoma i molekula kroz SNMS mode (Masena spektroskopija sekundarnih netralnih čestica, Sputtered Neutral Mass Spectroscopy). Neutralni atomi izbačeni s površine uzoraka za vrijeme ionskog bombardiranja prije ulaska u kvadrupol se ioniziraju pomoću elektronskog izvora.
Projekti u kojima će se SIMS intenzivno koristiti uključuju, među ostalim, analizu materijala za biomedicinske primjene ili materijala za konverziju sunčeve energije i pohranu energije, koje ćemo modificirati u našim laboratorijima drugim sofisticiranim tehnikama.
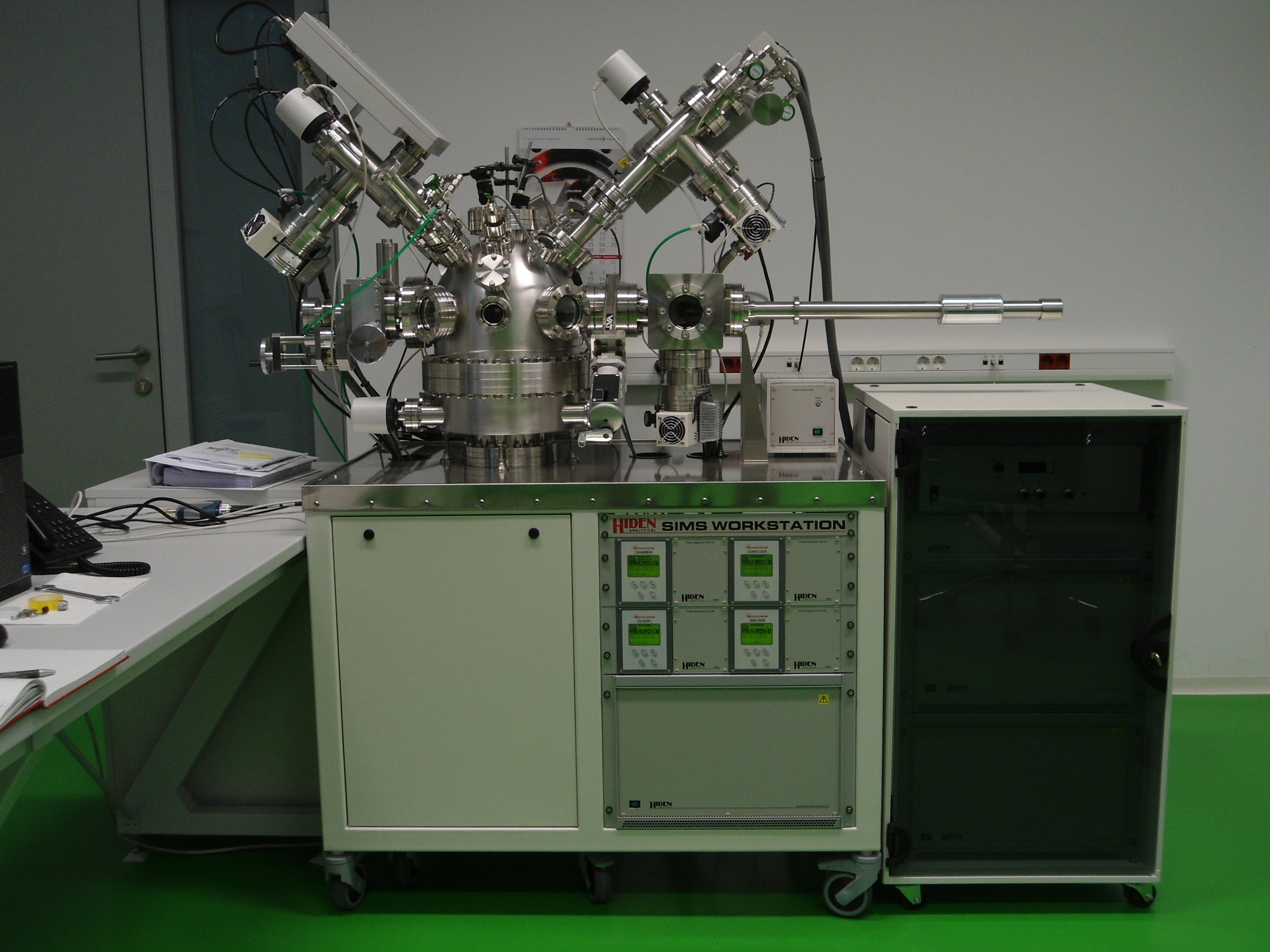
 |
Bruker DektakXT™ stylus profilometar površina koristi se za mjerenja fizikalnih varijacija na površinama na nanometarskoj razini. Prvenstveno ga koristimo za određivanje dubine kratera nakon SIMS/SNMS analize i za mjerenja hrapavosti površina. |









